微纳加工平台 是集微纳制造技术研发、公共服务、产业化为一体的多功能的公共开放平台,规划建设超净实验室约14000平方米,以专业化的团队、先进的设备工艺及完善的基础设施搭建科研与产业的桥梁,围绕硅基MEMS、GaN基芯片、生物传感等芯片加工需求,面向企业、高校、院所开展化合物材料外延、Si和GaN基芯片制造、封装测试全流程服务,服务覆盖微纳电子、传感器、光电子器件、功率芯片、生物芯片等众多领域。
微纳加工平台在半导体研发和小试服务的丰富经验,立足佛山,面向广东,辐射粤港澳大湾区,以开展8英寸及以下产品的中试代工为主,让企业、高校、科研院所以轻资产、低门槛的方式专注核心竞争力的构建,加速成为科技和产业领域的领军者。
- 专业、共享
以专业的技术团队和成熟的半导体器件加工能力服务客户,实现半导体装备、基础工艺等平台资源的高度开放和共享。
- 优质、高效
以客户需求为中心,以高水平的技术团队为基础,以先进的制造管理体系为依托,以效率优先的理念为客户提供安全、高效的服务。
- 创新、合作
紧随半导体前沿技术和发展趋势,结合客户工艺需求,不断开发新工艺和新技术;通过项目联合申请、产品合作研发等多种形式同国内外相关企事业单位开展合作。
- 圆芯基地
半导体微纳加工平台努力成为半导体企事业单位圆梦芯片、人才培养、产业孵化的首选基地和值得信赖的合作伙伴。
8英寸MEMS加工线
满足智能感知芯片制造应用的需求8英寸Micro-LED、8英寸HEMT加工线
满足显示、光通信、电力电子产业需求光电器件加工线
满足紫外、激光器产业的需求8英寸生物医疗芯片加工线
满足医疗健康等产业的需求
8英寸中试代工
利用已有技术为客户提供单步、短工艺、全流程等中试代工服务
半导体设备及耗材示范应用
评估国内外半导体设备及材料制造企业的产品,通过平台进行合作推广和试用,不断提升产品设计及用户体验

服务模式

小试研发及技术咨询
根据客户需求进行评估,客户自主研发,平台协助开发,确定最终工艺方案;帮助客户发现、解答芯片加工过程中疑难问题
委托加工
根据客户需求,出具技术加工方案,提供器件加工和测试的全流程服务

人才培养
组织半导体器件微纳加工工艺专业理论学习和技术培训;联合企业、高校开展专业人才培训和实践学习01
光刻
拥有双面紫外光刻机、DUV光刻机、多种型号的步进式光刻机及配套涂胶显影机、等离体子体清洗机、HMDS烘箱等多种光刻辅助设备,可满足4英寸、6英寸、 8英寸晶圆光刻工艺。
- 曝光分辨率:130nm-800nm
- 晶圆尺寸:8英寸向下兼容

02
镀膜
拥有等离子体增强化学气相沉积( PECVD )、低压化学气相沉积(LPCVD)、感应耦合等离子体化学气相沉积( ICPCVD )、原子层沉积(ALD)、多腔室磁控溅射、电子束蒸发台等镀膜设备,兼容8寸及以下晶圆。
- 可制备材料:
1. Ti、Al、Cu、Au、Cr、Pt、Ag、Mo、W、TiW、AuGe等金属及合金薄膜
2. poly Si、a-Si、SiO2、SiNx、TEOS SiO2、ITO、Al2O3、TiO2、TiN、AlN

03
刻蚀
拥有反应离子刻蚀(RIE)、电感耦合等离子体(ICP)、离子束刻蚀(IBE)、湿法刻蚀等多种类别的刻蚀设备,兼容8寸及以下刻蚀工艺。
- 刻蚀材料:
Si、SiO2、SiNx、a-Si、多晶硅、Au、Al、Cr、Ti、W、GaN、ITO等

04
注入
拥有中束流离子注入机设备,兼容8寸及以下的掺杂工艺,具备掺杂深度小(1μm以内),掺杂不受平衡固溶度的限制等优势。
- 注入能量:1keV-750keV
- 注入剂量:1E11~1E15 ions/cm2
- 注入元素:B、P、F、Al、N、Ar、Mg、H、Si等

05
封装
拥有化学机械抛光机(CMP)、键合对准机、晶圆临时键合机、晶圆永久键合机、大压力晶圆键合机、硅晶圆切割机,具备兼容6寸、8寸晶圆的键合、切割、减薄等封装设备。

06
检测
拥有场发射扫描电子显微镜(FESEM)、应力仪、椭偏仪、台阶仪、膜厚仪等多种类别的检测设备。

07
热处理
拥有快速退火炉、管式炉等类型热处理设备,兼容8寸及以下晶圆。
- 快速退火炉参数:
最高温度:1250℃
最大升温速率:≦30℃/sec for 纯 SiC 盘
工艺氛围:N2,Ar,O2

08
辅助工艺
拥有包括高温无氧烘箱、真空烘箱、喷金仪、喷砂机、全自动有机(无机)清洗台、全自动金属剥离机、手动有机(无机)清洗台等设备。

半导体芯片按照结构功能主要分为集成电路、分立器件、光电器件与传感器,根据芯片功能材料不同可分为硅基与化合物半导体两大类。芯片制造一般经过晶圆加工、材料外延、光刻、镀膜、刻蚀、离子注入、封装、测试等步骤,根据芯片功能进行不同工艺步骤组合、重复以形成特定材料生长及结构制造,实现器件性能。
Si高深宽比刻蚀工艺
具备Si材料的高深宽比刻蚀工艺能力,拥有成熟的Bosch工艺和非Bosch工艺,相关工艺在Si基MEMS传感器、TSV 3D封装、MOSFET和DRAM单元间的浅隔离槽等方面有广泛应用。
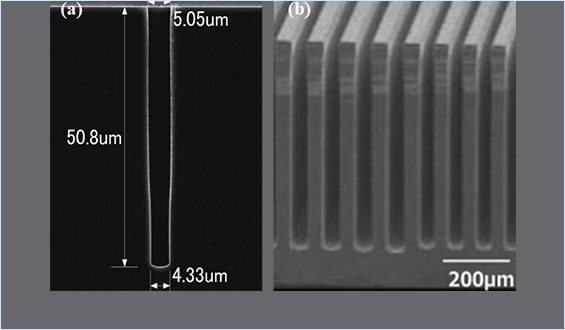
深 Si 刻蚀工艺 SEM的图 :(a) 非 Bosch 工艺;(b)-(c)Bosch 工艺
GaN低损伤刻蚀工艺
具备GaN、p-GaN、AlGaN等Ⅲ-Ⅴ族化合物材料刻蚀工艺能力,实现GaN的快速刻蚀和低损伤刻蚀工艺,兼容AlGaN的原子层刻蚀(ALE)工艺,相关工艺在GaN基光电子器件的Mesa刻蚀、隔离刻蚀、栅极刻蚀等方面有广泛应用。
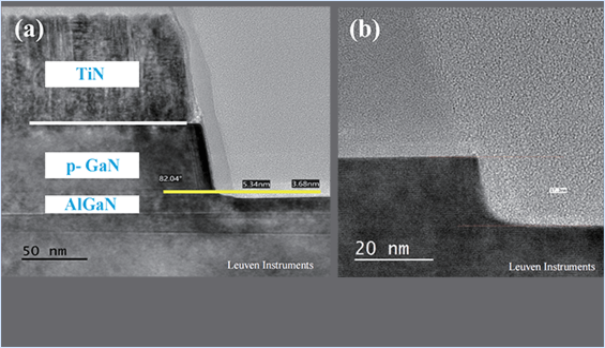
ICP 刻蚀 GaN 的 SEM 图 : (a)p-GaN 和 AlGaN 刻蚀结果;(b)AlGaN 刻蚀低损伤工艺
离子束刻蚀工艺
具备SiO2、SiNx、Al、Au、Ti、Pt、ITO等材料刻蚀工艺能力,载台倾角-90° ~ 80°,片内/片间/批间均匀性:≤ 5%。相关工艺在较难刻蚀的物质及金属、Pt薄膜温度传感器、射频MEMS(SAW/FBAR/BAW)的压电和电极刻蚀混合金属-介电材料的复杂磁性材料(AMR/GMR、TMR/MRAM)刻蚀等方面 有广泛应用。
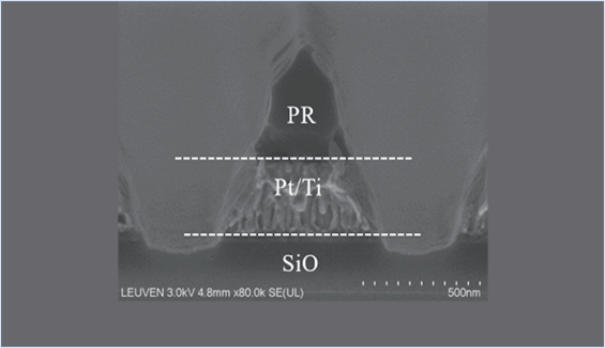
IBE刻蚀Pt/Ti的SEM图
晶圆键合工艺
基于阳极键合工艺可实现Si晶圆/具有表面图形结构Si晶圆与玻璃的键合。键合压力可控制在0-20KN,温度在0-450 ℃,电压:0-2000V,键合后图形对准误差≤±3μm。基于热压键合工艺可实现Au-Au键合,Au-Sn,Ge-Al键合。键合压力可控制在0-100KN ,温度在0-550℃,键合后对准精度≤±5μm。

阳极键合工艺图
隐形切割工艺
具备Si材料高精度,无损切割能力。隐形切割是通过红外激光将晶圆内部Si材料断裂,形成损伤层,实现晶圆高精度切割。可以实现Si晶圆表面无损伤切割。晶圆切割厚度可达750μm,切割速度达到800mm/s。

隐形切割工艺光学显微图
光刻工艺
接触式紫外光刻机可实现最小800nm的曝光分辨率,套刻精度±1μm ;DUV光刻机可实现8英寸晶圆最小130nm的曝光分辨率,套刻精度±25nm ;步进式投影光刻机可实现最小450nm的曝光分辨率 ,套刻精度±100nm,满足4英寸、6英寸、8英寸晶圆光刻工艺。
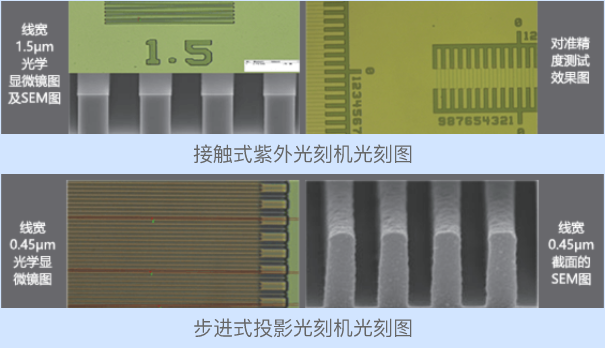
步进式投影光刻机光刻图
GaN Micro-LED工艺
已实现6英寸Si基GaN LED材料外延生长、256×192(15μm像素间距)被动式微型显示芯片、2560×1920超高分辨率红、绿、蓝单色微显示芯片工艺开发,像素密度可达到5000ppi、像素间距5微米。采用8英寸Si衬底GaN Micro-LED外延片与8英寸Si基CMOS微显示驱动晶圆直接键合技术路线,形成了一套完整的制备8英寸高分辨率芯片工艺流程。以量子点光刻技术实现单片红、绿、蓝全彩图像显示,并将全彩Micro-LED成功应用于小体积近眼显示模组中。
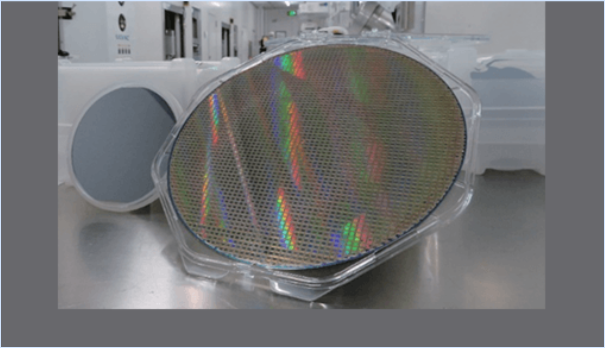
8英寸Micro-LED微显示晶圆片
GaN基增强型HEMT器件工艺
采用H等离子体处理p-GaN增强型电力电子器件方案,解决了p-GaN刻蚀损伤和精确控制问题。目前已实现50mm栅宽p-GaN栅增强型 GaN HEMT制备,阈值电压2.3V(通过最大跨导方式定义),最大漏极电流ID为13.7A@VGS = 6V (274 mA/mm),最大跨导Gm为4.7S@VGS=3.9V(94 mS/mm),正反向扫描的阈值回滞仅为45 mV且开关比达到了~109,导通电阻RON为235 mΩ(11.75Ω•mm),正反向扫描几乎无回滞现象。850V关态电压,漏电流为0.01 µA/mm。

GaN基增强型HEMT器件
低温高质量介质膜沉积工艺
具备SiO2 、SiNX 、非晶硅等材料低温(20~180℃)沉积工艺,沉积速率SiO2和SiNX均可实现≥15nm/min,薄膜应力绝对值达到SiO2≤ 300MPa和SiNX ≤ 500MPa,BOE腐蚀速率(BOE(7/1)@RT) : SiO2 ≤ 300nm/min ;SiNX ≤ 50nm/min,片内和片间均匀性< ± 5%。相关工艺在面向剥离技术的低温沉积、微米级沟槽填充、MEMS压力传感器、GaN基光电子器件等方面有广泛应用。
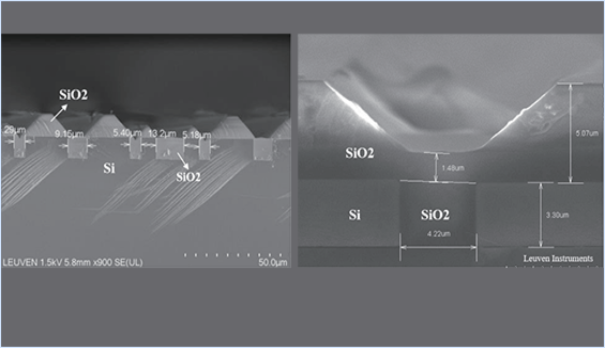
ICPCVD微米级沟槽填充SiO2工艺的SEM图
技术咨询
- 邮箱:jgpt@sinanogd.ac.cn
- 电话:0757-88591819
投诉与意见反馈
- 邮箱:dszhao2019@sinanogd.ac.cn
- 电话:0757-88591811



